名古屋工业大学大学院工学研究科加藤正史副教授、名古屋大学未来材料与系统研究所原田俊太副教授及住重Atex公司组成的研究团队,通过注入氢离子成功抑制了导致SiC功率半导体劣化的晶体缺陷扩张。
SiC功率半导体中存在的问题是,当增大二极管电流时,被称为“堆垛层错”的晶体缺陷就会扩张,扩张后的堆垛层错会使电阻增大。
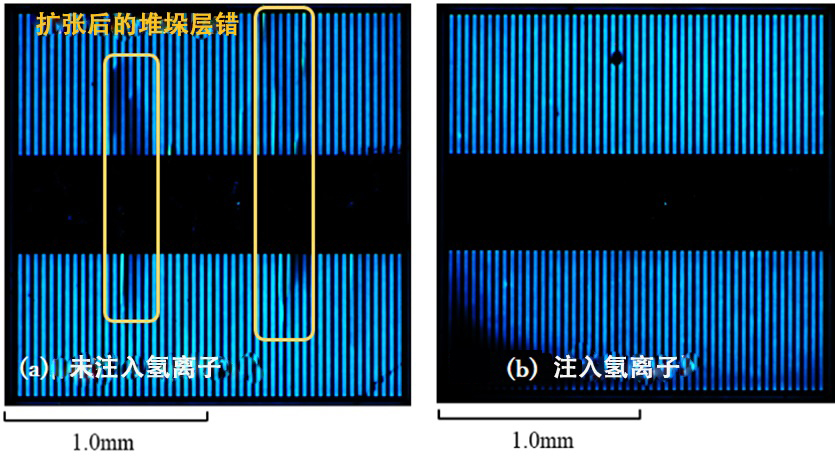
图1:长时间通电劣化试验后,从二极管电极窗观察到的EL图像。(a)未注入氢离子的二极管;(b)注入氢离子的二极管(供图:名古屋工业大学)
研究团队通过MeV级能量离子加速器进行氢离子注入,在外延层/衬底界面附近导入氢和点缺陷。通过此举使氢或点缺陷固定,阻止其运动,以此来抑制堆垛层错的扩张。研究团队针对据此开发的制作工艺所制作的二极管,进行了长时间的电流负载试验,之后观测了电致发光(EL)图。EL可以通过在外延面上形成的条纹状开窗电极进行观测,堆垛层错在EL图中显示为暗部,由此可判断堆垛层错有无扩张。在没有注入氢离子的二极管中,确认到了多处暗部,可知堆垛层错发生了扩张。而注入了氢离子的二极管中没有观测到堆垛层错。因此确信,氢离子的注入抑制了堆垛层错的扩张,有望成为解决双极性劣化的技术。
加藤副教授表示:“我们将继续研发,以找到能让SiC功率半导体能兼顾性能和长期可靠性的氢离子注入的最佳条件,并希望将来能将此技术提供给SiC功率半导体制造商。”
原文:《科学新闻》
翻译:JST客观日本编辑部
【论文信息】
学会:19th International Conference on Silicon Carbide and Related Materials 2022
论文:Suppression of recombination enhanced dislocation glide motion in4H-SiC by hydrogen ion implantation
URL:icscrm2022.org/
学会:19th International Conference on Silicon Carbide and Related Materials 2022
论文:Suppresion of stacking fault expansion in SiC PiN diodes by H+implantation
URL:icscrm2022.org/