Rigaku Holdings Corporation旗下的株式会社Rigaku(东京都昭岛市)宣布开发出了利用超高分辨率X射线显微镜对3D闪存缺陷进行无损检测和测量的突破性技术,并凭借此项研究成果获得了半导体光刻技术领域最佳论文奖“The Diana Nyyssonen Memorial Best Paper Award”。

左起:获奖人X射线研究实验室总经理表和彦(Omote Kazuhiko)以及X射线实验室先进分析技术研究部成像组的广濑雷太(Hirose Raita)(供图:Rigaku Holdings Corporation、株式会社Rigaku)
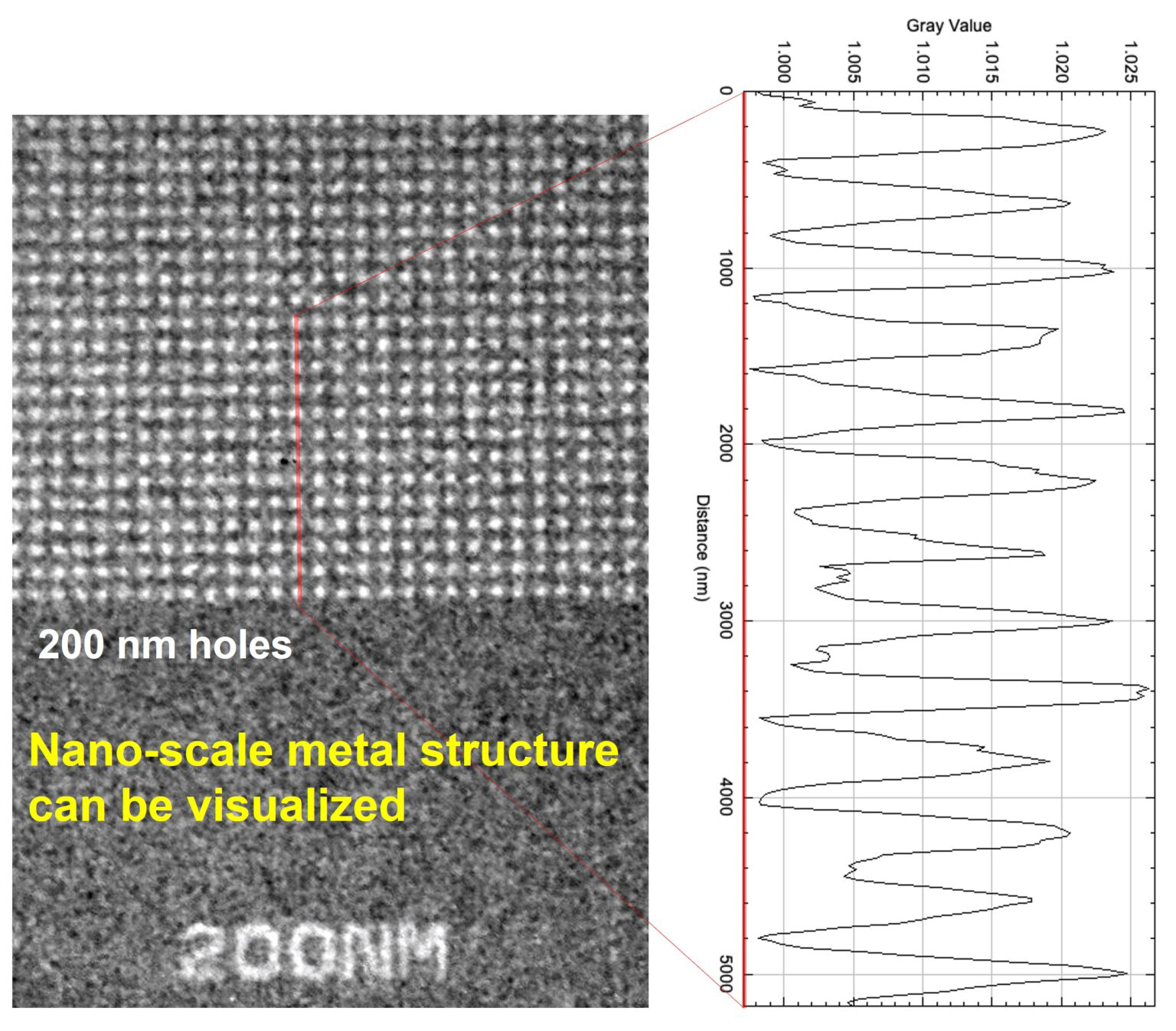
使用该技术检测和测量的硅片中200纳米级孔图案(供图:Rigaku Holdings Corporation、株式会社Rigaku)
该奖项由发布半导体制造光刻技术领域最新研究成果的国际学术会议“SPIE Advanced Lithography+Patterning Conferences”颁发,授予在测量、检测与工艺控制领域最优秀的论文。
该奖项是为纪念在光刻技术领域作出重大贡献的学者Diana Nyyssonen女士而设立,旨在表彰其卓越学术功绩。
在3D闪存制造过程中,对嵌入式金属结构及被称为存储孔的深孔形貌进行检测与测量一直存在难点。
Rigaku发布的新技术通过采用X射线检测,实现了不到光学显微镜检测极限10分之1的超高分辨率。该奖项的颁发是为了表彰这一突破性解决方案,它不仅使人们有可能看到纳米级的极小尺寸,而且还能对硅衬底上形成的器件进行无损观察。
搭载此项技术的设备若应用于3D闪存产线,将有望提高良品率并优化制造工艺。该公司计划在2年内完成该技术的设备集成工作。
此外,未来的目标是将该技术应用于更多创新,例如,应用于多层器件连接部位的缺陷检测与测量等。
【获奖论文详情】
标题:Non-Destructive Investigation for Metal Structure in 3D Flash Memory by an Ultra-High Resolution X-ray Microscope
URL:https://rigaku-holdings.com/pdf/Proc.%20of%20SPIE%20Vol.%2012955%20129551B.pdf
原文:《科学新闻》
翻译:JST客观日本编辑部













